iST 宜特服務優勢
案例分享
- 偵測極限可達ppma(1E-6)甚至ppba(1E-9)
- 可偵測週期表上所有元素(H~U)
- 可區分同位素
- 縱深解析度最佳可達2nm
- 可分析導電不良樣品
- 經由標準品比對可作定量分析
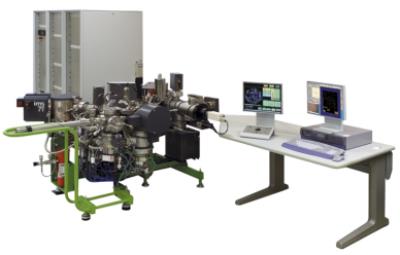
CAMECA 6F-E7
| 離子源 | 銫(Cs) 源: 2~10kV 氧(O2) 源: 1.1~15kV |
| 偵測極限 | ppma ~ ppba |
| 偵測元素 | H~U |
| 質量解析 | >20,000 |
| 分析面積 | >10um |
- 半導體產業
- LED產業
- 光電產業
- PCB產業
二次離子質譜分析儀 (Secondary Ion Mass Spectrometer, SIMS)主要是利用離子高靈敏度的特性,針對樣品的表面微汙染、摻雜與離子植入的P/N濃度定量分析,以及P/N介面擴散的研究。廣泛應用於半導體、LED,以及薄膜材料的微量檢測分析上。
iST的SIMS高解析度,除了針對離子植入、摻雜量的P/N濃度定量分析外,還可進行P/N介面擴散的深度分析(Junction Depth),以及BULK材料中微量元素的濃度分析。為您精準控制半導體/LED製程的參數,以維持元件/磊晶穩定性。

高質量解析力(M/ΔM):>20,000
高縱深解析度:小於2nm/decade
超高真空度:低於1E-9mbar (Ion on)
極佳偵測極限:可達1.0E13atom/cm3(ppba)以下(Si 基材之As摻雜)
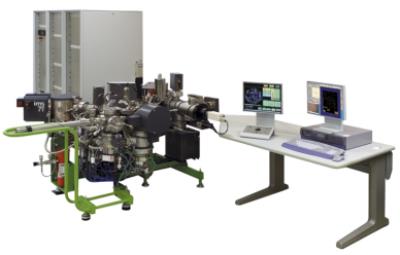
| 離子源 | 銫(Cs) 源: 2~10kV 氧(O2) 源: 1.1~15kV |
| 偵測極限 | ppma ~ ppba |
| 偵測元素 | H~U |
| 質量解析 | >20,000 |
| 分析面積 | >10um |