發佈日期:2024/4/16 差排軌跡
發佈單位:iST宜特
在晶片製造過程中,差排是一個相當棘手的問題,這個微小缺陷可能會引發半導體元件的漏電流,進而嚴重影響元件的可靠性。TEM是目前唯一能觀察到微小差排的分析工具。但要充分發揮其威力,需要相當的技術與知識。你會使用TEM這個超級工具分析差排軌跡嗎?今天也讓我們一起解鎖更多TEM技巧吧!
差排軌跡
先前我們提過,第一類半導體材料為矽和锗,由於晶圓提煉技術成熟,單晶晶片中的缺陷密度非常低,通常只有零度空間型的空缺(vacancy)缺陷,而一度空間型的差排(dislocation)缺陷濃度近乎零。(延伸閱讀:氮化鎵磊晶層差排類型分析唯一利器 如何用TEM解開謎團)然而,在離子佈植的製程中,如果熱處理程序不當,就會在半導體元件的主動區殘留一些差排晶體缺陷。主動區內的差排如果穿過p-n 接面就會變成漏電流的通道,降低元件的可靠性。
TEM (穿透式電子顯微鏡,簡稱TEM) / STEM(掃描穿透式電子顯微鏡,簡稱STEM)是目前唯一看得到差排的奈米材料分析技術。透過特定的繞射條件,TEM/STEM影像可以推算差排密度和差排類型[1 ~ 3],而TEM三維立體成像技術則可以分析差排在三度空間的延伸軌跡 [4 ~ 6]。
本文將探討如何以TEM三維立體成像技術,分析半導體元件矽基板內差排的延伸軌跡。對於漏電型失效的半導體元件,分析差排的延伸軌跡是TEM分析的重要工作。
差排軌跡
差排軌跡
一、TEM三維立體成像技術簡介
近代TEM/STEM的功能強大,擁有超過十種微奈米材料分析的技術。其中,可以用來分析差排在晶體內部三度空間延伸軌跡的技術有三:TEM斷層掃描術(TEM tomography)[5, 6]、3D TEM和TEM立體影像(TEM stereo)[1, 3]。
(一) TEM斷層掃描術(TEM tomography):
最先進也最精確,但是操作過程過於複雜繁瑣和耗時,主要用於學研界的TEM實驗室,不適於產業界的一般工程師操作,而且試片包含的範圍也通常過於狹小。
(二) 3D TEM:
通常是先用平面型試片做第一次TEM觀察,看到差排後對該區塗佈適當的保護層後,再進行一次聚焦離子束(FIB)切割,容易損傷試片,也可能切掉部分差排,導致資料錯誤。
(三) TEM立體影像(TEM stereo)術:
相對上述兩者,此技術只需要做一次TEM試片,從二個角度保持同樣的繞射條件觀察,藉由基本的幾何量測與運算,即可描繪出差排的延伸軌跡。此法的試片製備相對簡單許多,成功率較高。
二、遠方海上的帆船
三、TEM影像的場深和景深
圖三是一組簡易的薄凸透鏡成像光路圖(ray diagram),左側標示O的黃色箭頭是物體,右側標示I的藍色箭頭是在成像面的倒立放大實像。固定成像面的位置,前後移動物體在Dfd距離範圍內,在成像面上的影像仍在清晰範圍,此Dfd稱為場深(depth of field)。固定物體的位置,前後移動成像面Dfs距離範圍內,在成像面上的影像仍在清晰範圍,此Dfs稱為景深(depth of focus);α角是物體中心點連接透鏡邊緣和光軸的夾角。場深和景深是透鏡的解析度與α角的函數。一般而言,操作電壓為200KeV的TEM,其場深和景深分別約為400 nm和1000 m。如此大的場深,意指TEM試片內的結構,從表面到底面都在清晰聚焦,所以單從一張TEM影像無法判斷二個特徵物在試片內的相對深度,如圖四(a)中的黃線和藍線。
圖四(a)中的影像對應的顯微結構,可能是圖四(b),也可能是圖四(c)。也就是說,單從圖四(a)一張影像無法作正確的判斷。如果將試片做如圖五(a)的逆時針傾轉某角度後,得到的第二張影像,此時黃藍二線的間距變大,如圖五(b)所示,則可以推斷樣品的結構是圖四(b)的結構,而非圖四(c)的結構。
四、差排在晶體內的延伸軌跡
在材料學上,差排在晶體某個位置產生後,除非形成一封閉迴路(loop),否則不會終止在晶體內。所以,半導體元件在離子佈植後,因不適當的熱處理 ,而在矽基板接近表面處產生的差排會在矽晶體內延伸。如果這些差排往下延伸穿過p-n界面,則形成一漏電流的通道。
透過類似圖五(a)中的試片傾轉,差排在試片厚度方向的延伸軌跡可以被分析出來。因為組成差排的矽原子和基材(matrix)的矽原子完全相同,差排在TEM明場像中的明暗對比機構只有繞射對比,所以繞射條件影響了差排的形貌,甚至導致整條差排消失不見。要準確地分析差排,必須採用雙束繞射條件(two beam diffraction condition),加上適宜的偏移參數(deviation parameter)。所以從二個相距15 ~ 20度的角度分析同一組差排時,必須盡量保持同一種雙束繞射條件,以確保被分析的差排形貌在二張不同角度的TEM明場像中保持大致不變。
圖六是一組典型的TEM立體影像。圖六(a)是一在[100]正極軸拍攝的TEM明場像,二條待分析的差排分別標示處A和B,右下角鑲嵌的是對應的聚束電子繞射(CBED)圖案。圖六(b)和圖六(c)是以圖六(a)為中心處,往相反方向各傾轉約8度,但保持相同雙束繞射條件的TEM明場像。影像中, A、B二差排的間距,在圖六(b)中明顯小於在圖六(c)中(d1 < d2);差排A和主動區邊緣(紅色虛線標註處)的距離L,在圖六(b)中則明顯大於在圖六(c)中。以上這些間距變化的現象和圖舞中陳述的現象類似,此結果可以初步推論出差排A和差排B在試片的不同深度。
藉由主動區邊緣當參考線,量測差排A和差排B在二影像中轉折點和主動區邊緣的距離,再運用基本的幾何運算,推算出差排A和差排B在矽基板內的延伸軌跡如圖七所示。差排B只在試片表面延伸,但是差排A的深度達260奈米,已經貫穿p-n界面,顯然是此漏電型失效元件的漏電渠道。
TEM是目前唯一可以分析晶體材料內部晶體缺陷,例如差排等的微奈米材料分析技術。TEM除了可以分析差排的型貌、密度和種類外,藉由TEM立體影像技術還可以分析差排在矽基板內的延伸軌跡,從而判斷該差排是否貫穿p-n界面,形成一個漏電的渠道。若能深入利用TEM的功能,將可更全面地理解材料的微細結構和特性,提高元件異常的分析能力。
宜特材料分析實驗室在半導體製程、先進封裝領域上耕耘已久,有相當豐富的經驗與成功案例。本文與長久支持宜特的您分享,若有相關需求,或是對相關知識想要更進一步了解,歡迎洽詢 marketing_tw@istgroup.com。
參考文獻:
[1] J. W. Edington, Practical Electron Microscopy in Materials Science, Van Nostrand Reinhold Company, New York (1976). ISBN: 0-442-22230-0
[2] G. Thomas and M. J. Goringe, Transmission Electron Microscopy of Materials, John Wiley & Sons, Inc., New York (1979). ISBN: 0-471-122440-0
[3] David B. Williams and C. Barry Carter, in Transmission Electron Microscopy, Microscopy, part 2, Plenum Press, New York (2007). ISBN: 0-471-122440-0
[4] 鮑忠興, “穿透式電鏡三維立體成像術”,科儀新知第三十卷第二期,48-54 (2008)。
[5] G.S. Liu, S.D. House, J. Kacher, M. Tanaka, K. Higashida, I.M. Robertson, “Electron tomography of dislocation structures”, Material Characterization, Vol. 87, 1-14 (2014)
[6] Alexandre Mussi, Ahmed Addad, Fabien Onimus, “Dislocation electron tomography: A technique to characterize the dislocation microstructure evolution in zirconium alloys under irradiation”, Acta Materialia, Vol. 213, 116964 (2021).
[7] J. S. Bow and Speed Yu, “Depth Measurement of Dislocations in Si Substrate by Stereo TEM,” Proc. ISTFA, 233-234 (2005).



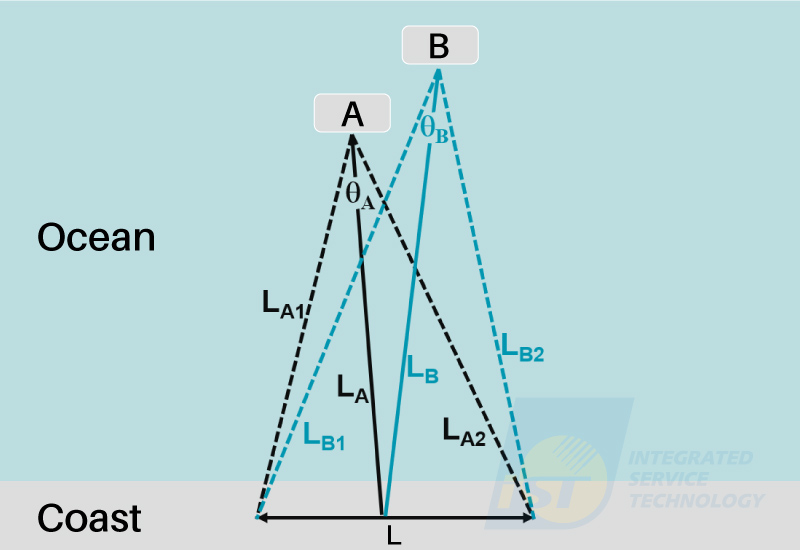

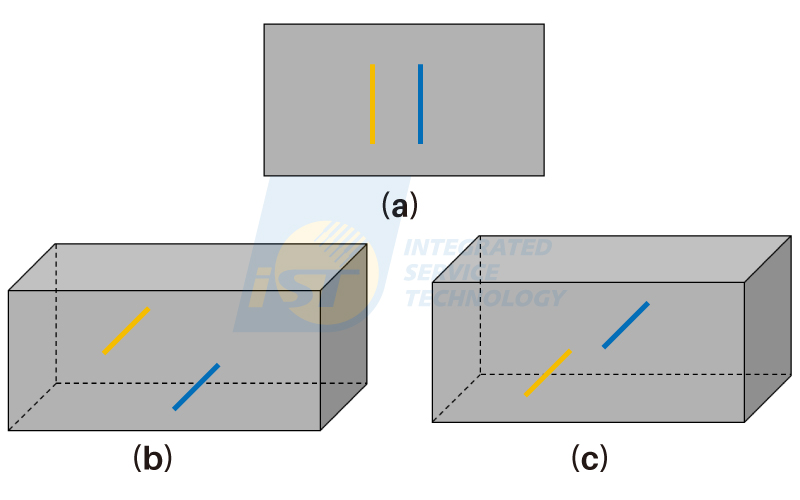
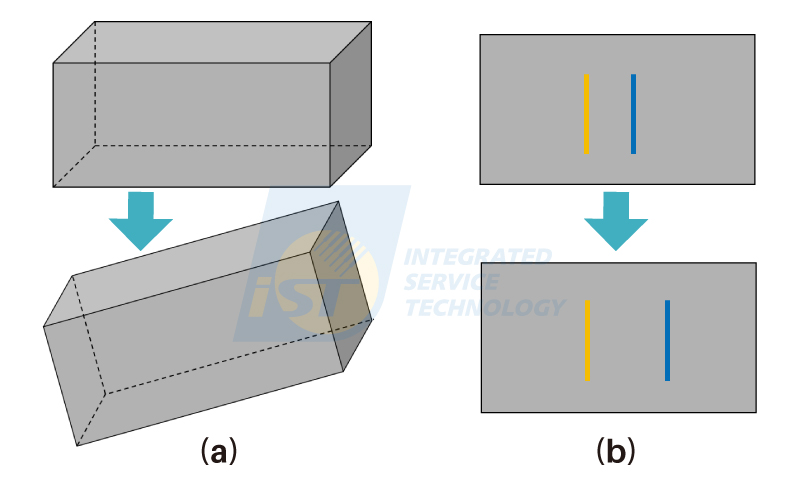
![差排軌跡。圖6是一組典型的TEM立體影像。圖6(a)是一在[100]正極軸拍攝的TEM明場像,二條待分析的差排分別標示處A和B,右下角鑲嵌的是對應的聚束電子繞射(CBED)圖案。圖6(b)和圖6(c)是以圖6(a)為中心處,往相反方向各傾轉約8度,但保持相同雙束繞射條件的TEM明場像。影像中, A、B二差排的間距,在圖6(b)中明顯小於在圖6(c)中(d1 < d2);差排A和主動區邊緣(紅色虛線標註處)的距離L,在圖6(b)中則明顯大於在圖6(c)中。以上這些間距變化的現象和圖5中陳述的現象類似,此結果可以初步推論出差排A和差排B在試片的不同深度。](https://www.istgroup.com/tw/wp-content/uploads/2024/04/tech_20240416-06-TEM.jpg)