發佈日期:2023/4/25 TEM樣品製備
發佈單位:iST宜特
水能載舟亦能覆舟,慣性思維可以讓你熟能生巧,
但也可能讓你因此迷失試片中的重要訊息!
本文鮑伯以自身實例說明,人類的慣性思維如何錯置TEM材料分析的結果
TEM樣品製備
物理學上,一個沒有受到外力的物體會沿一直線以等速度持續前進,稱之為慣性。而在我們日常生活例行性的交通中,從A處到B處,已經習慣某條行車路線後,如果臨時想去C處買個小東西,在前往途中,一不留神就會在必須轉彎的街口繼續沿舊路線前進。個人將此種行為稱之為「慣性的迷失」。對於許多人來說,慣性的迷失在日常生活中經常發生,大多無傷大雅。但是如果發生在工程案件和商業案件中,則會造成相當程度的損失,小則浪費幾天的人力和物力,大則危及企業的資本。
TEM樣品製備
TEM樣品製備
案例一:慣性思維導致測試無限輪迴,還差點延宕了交期?
廿幾年前,在工研院材料所微結構分析實驗室工作。某天接到一個半導體元件良率的案子,客戶送來二組表面長有磊晶層的矽晶圓。經過相同的製程,用A組晶圓製作的元件的良率都低於50%,而用B組晶圓製作的元件的良率則高於95%。客戶要鑑定A組晶圓內的磊晶層是否有造成低良率的缺陷。利用TEM(穿透式電子顯微鏡,Transmission Electron microscopy, 簡稱TEM)進行樣品的橫截面分析。第一天,完成A組晶圓的TEM試片製作,在TEM中,觀察到矽磊晶層和矽基板的界面有幾個數奈米大小的空孔。第二天,完成B組晶圓的TEM試片製作,但是在TEM中找不到矽磊晶層。當時推估是沒有磨對位置。第三天,再製作第二個B組晶圓的TEM試片,仍然找不到矽磊晶層。
第四天,預定交付資料的前一天,完成第三個B組晶圓的TEM試片,在TEM中搜尋一遍後,仍然找不到矽磊晶層。此時已經晚上11點。疲乏的我走到室外散心,順便思考今晚是否要研磨第四個B試片,以及如何向客戶提出延期的說詞。沈思中,忽然靈光一閃,天啊!摻雜濃度等級(ppm)的矽同質磊晶層和矽基板之間,正常狀況下,本來就看不到界面。
一直想要看到磊晶層和矽基板的界面,是因為被A試片的觀察結果引導,以及以往分析異質磊晶層樣品的經驗造成的慣性思維。從A試片中,得知磊晶層厚度是50奈米,所以我只要先確定B試片的表面是平直無損,再從試片距離表面50奈米的深度處,劃一平行表面的直線延伸整個TEM分析的試片範圍,在此直線的附近找不到任何缺陷,即能證明B試片的磊晶層矽和矽基板之間沒有缺陷。
中場休息:您是否也曾跟男主角一樣,落入慣性的陷阱呢?
在分享下個案例之前,突然想起一個慣性迷失的笑話。
一對年輕情侶在公園漫步。意外地,一隻蚊子撞到女主角的眼睛,男主角趕快幫女主角吹眼睛,同時溫柔地說:「妳的眼睛好大」。
女主角一邊眨眼流淚,一邊高興地微笑。二人繼續愉快地邊走邊說。
忽然,一隻蚊子恰好飛入正在說話的女主角口中。男主角趕快幫女主角擦拭口水,同時溫柔地說:「妳的嘴巴好大」。…..不知道這男友下場如何,回到正題。
案例二:照慣例來不行嗎?樣品製備角度差一點,結果竟然截然不同?
現在矽基半導體元件的TEM分析主要分成二個主要階段:FIB樣品製備和TEM分析。由於絕大多數的矽基半導體元件使用[001]晶圓製作,電晶體元件沿二個互相垂直的{110}方向排列。因此,在第一階段,FIB工程師習慣上沿某一[110]方向切出TEM試片。在第二階段,TEM工程師也習慣上,一定是先將TEM試片傾轉,使試片的[110]方向和入射電子束的方向一致,然後再進行後續的分析。
[001]、{110}或[110]等都是用來表示晶體方向與晶面的一種指數,稱為米勒指標(Miller index),是晶體學(Crystallography)中用來確定固體中原子或離子排列方式的一種表示法。
圖1(a)顯示一張FIB的二次電子影像。圖中黃色箭頭所指之處,第一層金屬(M1)和鎢栓(W)非常接近。由於解析度的問題,此影像無法確認第一層金屬和鎢栓是否已經接觸?或是尚有空隙?因此必須進行TEM分析。這個特殊案子的TEM樣品製備,理想上應該是照著如圖1(b)中虛線矩形的輪廓切挖成TEM試片,才能看清楚第一層金屬和鎢栓是否已經接觸。可是由於慣性思考使然,FIB工程師仍然照慣例,沿矽基板的[110]方向切挖,按照如圖1(c)中虛線矩形的輪廓做出TEM試片。
如果TEM工程師也是照慣例,先傾轉TEM試片,使試片矽基板的[110]正極軸方向和電子束一致,然後拍攝影像,得到如圖2(a)的影像。得到的結論將是第一層金屬的腰部和鎢栓是接觸的。可是若跳脫慣性思維,將TEM試片做適當的傾轉後,使觀察方向接近沿圖1(b)中的黃色虛線AB方向時,可以發現第一層金屬的腰部和鎢栓雖然很接近,但是仍有幾奈米的間隙,如圖2(b)所示。從圖2(a)和圖2(b)得到的訊息,對於設計工程師或製程工程師而言,修正的工作有相當程度的差異。
慣性思維能幫助我們熟能生巧,但是對於非例行性的案子,制式化的慣性操作,只是得到大量排列整齊的影像和若干組彩色的成份映像而已,TEM強大的分析功能並未被充分發揮,真正的材料訊息仍遺留在試片內,或者未被用適當的TEM分析技術顯像出來。
本篇是宜特材料講堂-鮑伯開講的首發文章。鮑博從每個人多少都會有的慣性思維,探討在運用TEM進行材料分析時卡關的實例。您也曾落入慣性思維的陷阱嗎?希望這篇文章能幫助您跳出慣性,在生活和工作中皆有所突破。
宜特材料分析實驗室在半導體製程、先進封裝領域上耕耘已久,有相當豐富的經驗與成功案例。本文與長久支持宜特的您分享,若有相關需求,或是對相關知識想要更進一步了解,歡迎洽詢 marketing_tw@istgroup.com。


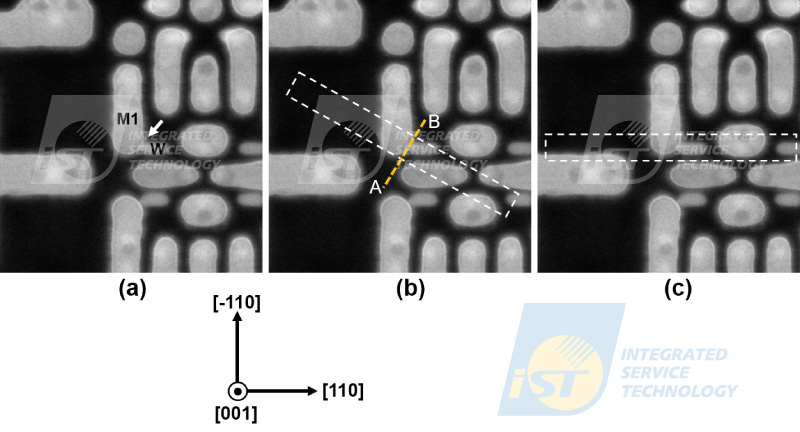
![TEM樣品製備 圖2. 橫截面型TEM明場像。(a)沿矽基板[110]正極軸方向拍攝的TEM明場像,顯示第一層金屬(M1)和鎢栓(W)接觸;(b)沿矽基板[001]軸傾轉20幾度後拍攝的TEM明場像,顯示第一層金屬和鎢栓未接觸。](https://www.istgroup.com/tw/wp-content/uploads/2023/04/tech_20230425-02-TEM.jpg)