發佈日期:2018/7/19
發佈單位:iST宜特
WLCSP的IC,錫球、RDL層覆蓋了電路層,該如何進行FIB電路修改?
什麼是WLCSP(Wafer Level CSP)晶圓級晶片封裝技術,這意指在晶圓切割前,利用錫球來形成接點,直接在晶圓上完成IC封裝的技術,比起傳統打線封裝,可有效縮減封裝體積;面對穿戴式、智慧手持式裝置輕薄化的趨勢,具有面積最小、厚度最薄等特徵的WLCSP封裝方式,也受到越來越多廠商採用。
然而此封裝形式的IC產品,在進行FIB線路修補時將面臨到兩大挑戰,一是IC下層的電路,絕大部分都會被上方的錫球(Solder Ball)與RDL(Redistribution Layer, 線路重布層)給遮蓋住,這些區域在過往是無法進行線路修補的。二是少數沒有遮蓋到的部分,也會因上方較厚的Organic Passivation(有機護層),大大增加線路修補的難度與工時(見下圖)。
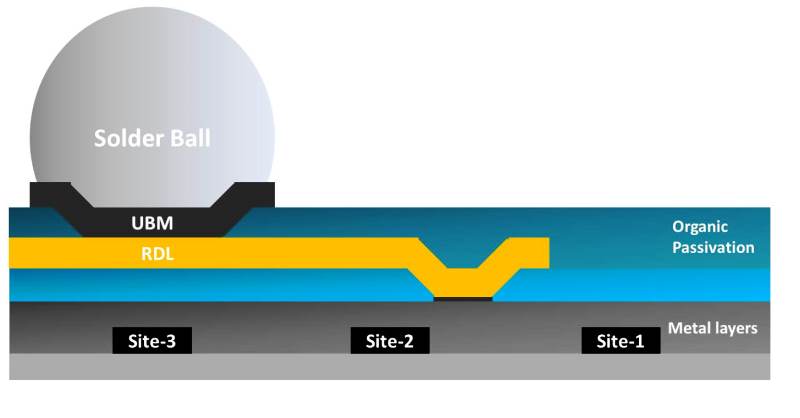
為此,宜特開發了WLCSP電路修改技術;為WLCSP製程所研發的蝕刻技術手法,無論要修改的目標區電路是覆蓋在Organic Passivation(有機護層)、或是RDL(重佈線路層,Redistribution Layer)、甚至錫球(Solder Ball)下方皆可進行電路修改;此技術至今,已為全球IC設計公司,包括電源管理、類比、多媒體IC設計等企業,解決2450件超過4600顆的WLCSP電路修改問題。
本月小學堂,我們從這2450件超過4600顆的WLCSP電路修改案件內,歸納出幾項客戶常見問題。
Q1: 想修改的WLCSP IC的電路位置,被錫球覆蓋,宜特進行電路修改後,該錫球還能夠使用嗎?
此分兩面向探討,第一,若您要做電路修改的位置,是在錫球邊緣,宜特可以提供「不破壞錫球高度並維持一定錫量」的局部錫球去除技術,在完成電路修改後,該顆樣品即可上到Socket或焊接到PCB上,進行後續電性測試。
第二,若您要做的電路修改位置,接近錫球中間下方,宜特將協助您移除該顆錫球,並在完成電路修改後,提供新的錫球植入,您一樣可以無縫接軌的進行後續實驗測試。
因此,在宜特WLCSP解決方案下,可以確保錫球功能正常與測試。
宜特移除局部錫球技術
修改位置在錫球邊緣時,僅需移除局部錫球,執行FIB電路修改後,可立即進行PCB焊接或直接上到Socket進行電路測試,加速您Debug時效。
宜特移除全部錫球技術
修改位置接近錫球中間時,選擇移除全部錫球,執行FIB電路修改後,搭配Laser Re-ball技術精準植球,提升整體電路修改可行性與成功率。
Q2: 已執行過FIB電路修改及焊接測試的WLCSP IC樣品,還可以二次進行電路修改嗎?
答案是可以。進行焊接測試後的WLCSP IC樣品,從測試板上拔下欲二次進行FIB電路修改,IC上的錫球將會是破碎不完整,因此,第一步驟必須先將WLCSP表面破碎的錫球清除乾淨,第二步驟,即可二次進行FIB電路修改技術,完成後,搭配宜特Laser Re-ball技術,精準植回錫球,您即可快速進行後續電性測試。
Q3: 如何有效率的植回錫球,且不影響後續可靠度驗證精準度?
以往,植回錫球的方式是人工擺球,以全面加熱方式讓錫球溶融後,接合於WLCSP IC的UBM層(Under Barrier Metal),此方式非常耗時; 且若其樣品是有PCB底板的產品(Ex: BGA封裝型式的IC),加熱的過程,很容易因PCB板材內藏有水氣,受到高溫影響,產生爆板現象,進而影響可靠度驗證精準度。
為此,宜特引進以雷射的方式植入錫球之技術(Laser Re-ball),藉此將可大幅提升作業效率與電路修改良率。
本文與各位長久以來支持宜特的您,分享電路修改經驗,若您有WLCSP電路修改問題、錫球植回需求,或是對相關知識想要更進一步了解細節,歡迎洽03-579-9909分機6092王先生(Chino)或分機6780邱先生(Shaun) │ Email: web_fib@istgroup.com;web_EFA@istgroup.com