iSTの強み
iSTは現在業界で主流の電界放出形走査電子顕微鏡(FE-SEM):Hitachi SU8600、Hitachi Regulus 8240、Hitachi SU8220、Hitachi SU8020に加え、EDS (SDD detector)を保有しています。これらにより、業界トップクラスの表面構造解析影像の提供を行い、迅速な材料成分分析を可能としています。さらに、YAG BSE 検出器も備えており、SEM は反射電子 (BSE) を使用して画像化できます。
事例紹介
- 各種材料表面の微小構造観察
- SEMによるサンプルサイズや膜厚などの測定
- EDSはサンプル表面微小部分の定性および半定量成分元素分析と特定エリアのPoint、Line Scan、Mapping分析を行います。
- EDS SDD detectorは低電圧下でMappingの空間解像度を上げることができます。
- SEMの自動撮影は、層毎の除去技術de-processと組み合わせることにより、回路のリバースエンジニアリングを提供できます。
- 低エネルギー電子ビーム走査による受動体コントラスト比較(Passive Voltage Contrast, PVC)を行い、半導体素子の異常な漏電または接触不良など、故障個所の正確な検出を行います。

HITACHI SU8020
- 電子銃:Cold FE
- 解像度:1.0nm (加速電圧15kV) ,1.3nm(加速電圧1kV)
- 倍率:30~800k
- 加速電圧:0.1~30kV
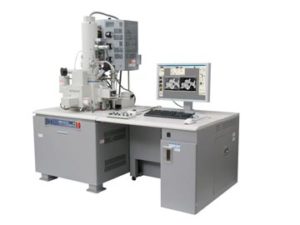
HITACHI SU8220
- 電子銃:Cold FE
- 解像度:0.8nm (加速電圧15kV) ,1.1nm(加速電圧1kV)
- 倍率:20~1000k
- 加速電圧:0.01~30kV

HITACHI Regulus 8240
- 电子枪:Cold FE
- 分辨率:0.7nm(加速电压15kV),0.9nm(加速电压1kV)
- 倍率:20~1000k
- 加速电压:0.01~30kV
- 自动拍照功能(Auto Capture)
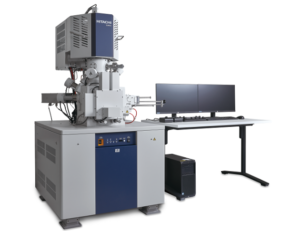
HITACHI SU8600
- 电子枪:Cold FE
- 分辨率:0.6nm(加速电压15kV),0.7nm(加速电压1kV)
- 倍率:20~1000k
- 加速电压:0.01~30kV