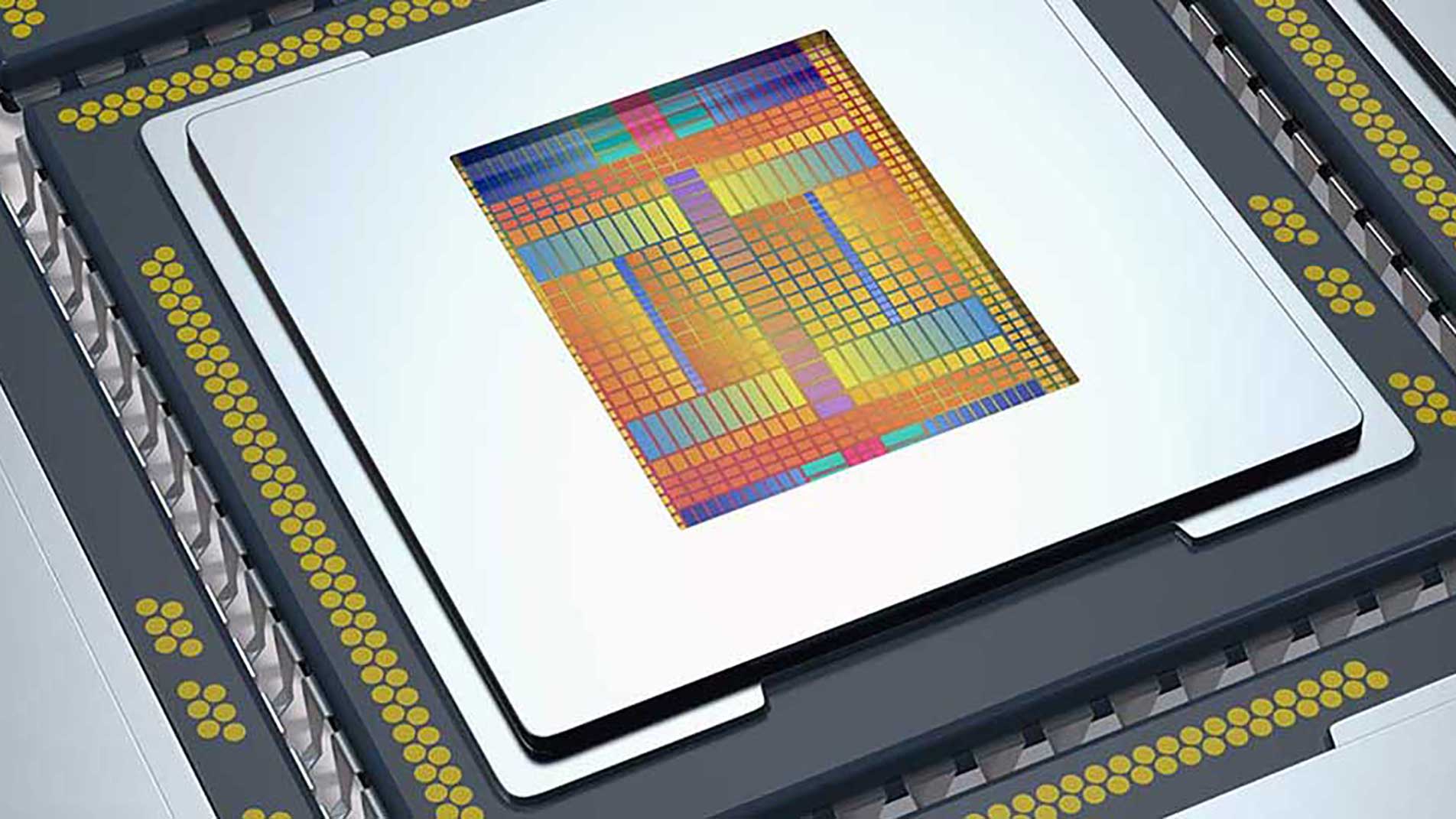
隨著摩爾定律當製程來到16奈米(nm)以下的製程,包裝型式多數為覆晶技術(Flip Chip),因此FIB電路修補就必須從晶片背面(晶背Backside)來執行…..

往往我們可以檢測的大多是固態樣品,但若遇到欲檢測的物品是液態,或者懷疑Defect來自於製程中的液態物質該如何分析呢?針對一般的樣品,以往我們會使用SEM檢測,然而….

隨著製程越來越進步,對於污染缺陷點的分析要求也越來越嚴苛。這些表面汙染缺陷,該如何選擇到位的分析方式呢?一般而言,若待分析汙染物屬於有機物範疇,我們會選擇….

打入車廠供應鏈,除了產品設計面外,還包括產品研發、生產、安裝、服務的部分必須有所依歸,此依歸準則,就是IATF 16949:2016汽車行業通用的品質管理體系…
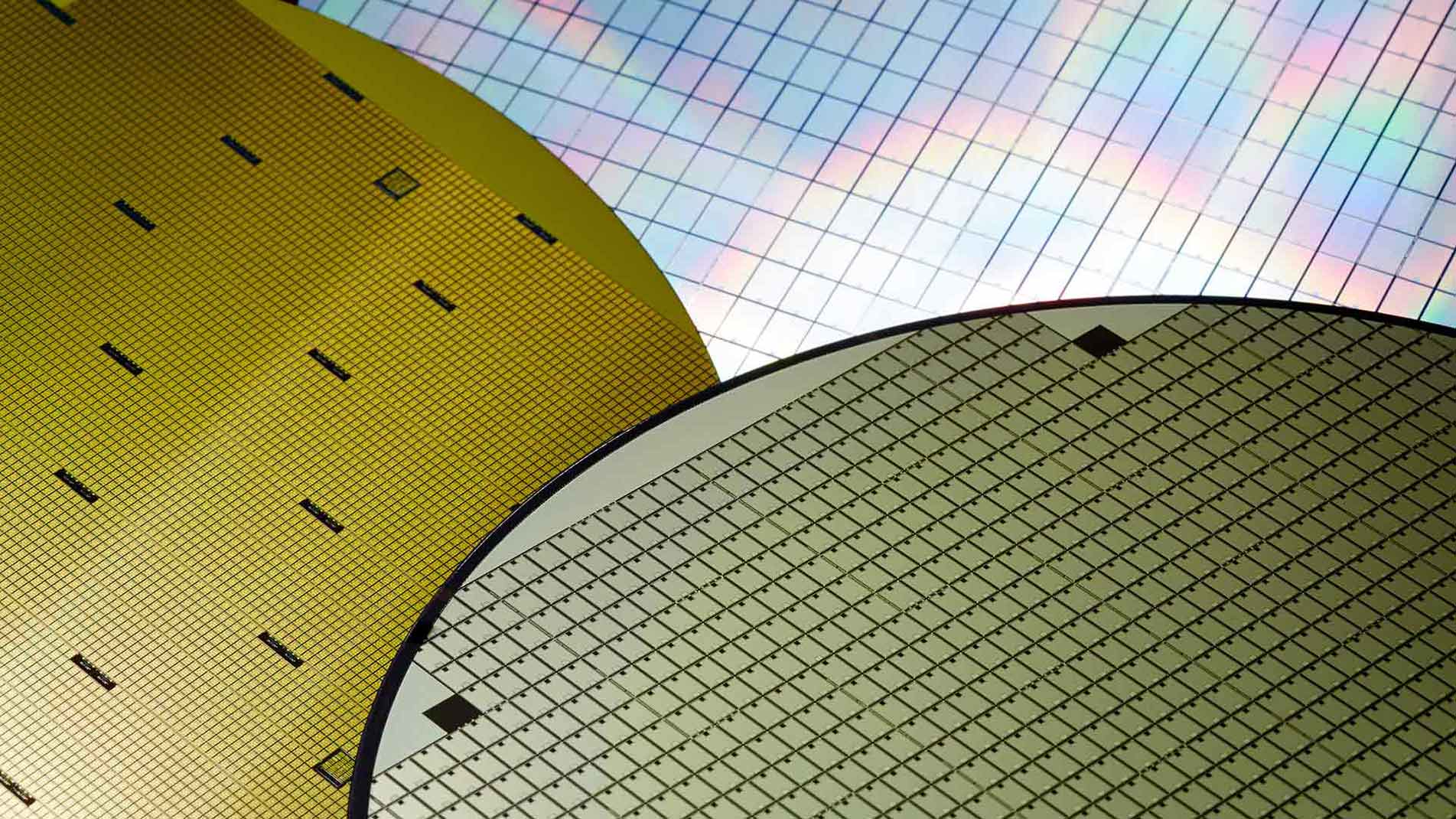
化鍍製程最大特色是,只需利用一系列的氧化還原反應,將鎳金/鎳鈀金選擇性的成長在鋁墊上,完全不需要經過高真空濺鍍/黃光製程/蝕刻製程,因此成本可降低…

正面金屬化製程是MOSFET晶圓薄化的一個關鍵製程,正面金屬化製程的目的,就是藉由濺鍍或化鍍方式形成UBM,接著做銅夾銲接 (Clip Bond),以降低導線電阻….
