
功率半導體進行「 晶圓薄化 」是改善製程,使得功率元件實現「低功耗、低輸入阻抗」最直接有效的方式。 但如何在薄化製程中降低晶圓厚度,又同時兼顧晶圓強度,避免破片率居高不下之風險…

正面金屬化製程是MOSFET晶圓薄化的一個關鍵製程,正面金屬化製程的目的,就是藉由濺鍍或化鍍方式形成UBM,接著做銅夾銲接 (Clip Bond),以降低導線電阻….

MOSFET在電子產品扮演「開關插座」的角色由來已久,各家MOSFET廠商也都以追求高效率的電力轉換、低功率耗損為目標。為達此一目標的捷徑,就是降低RDS(on)(導通阻抗)…
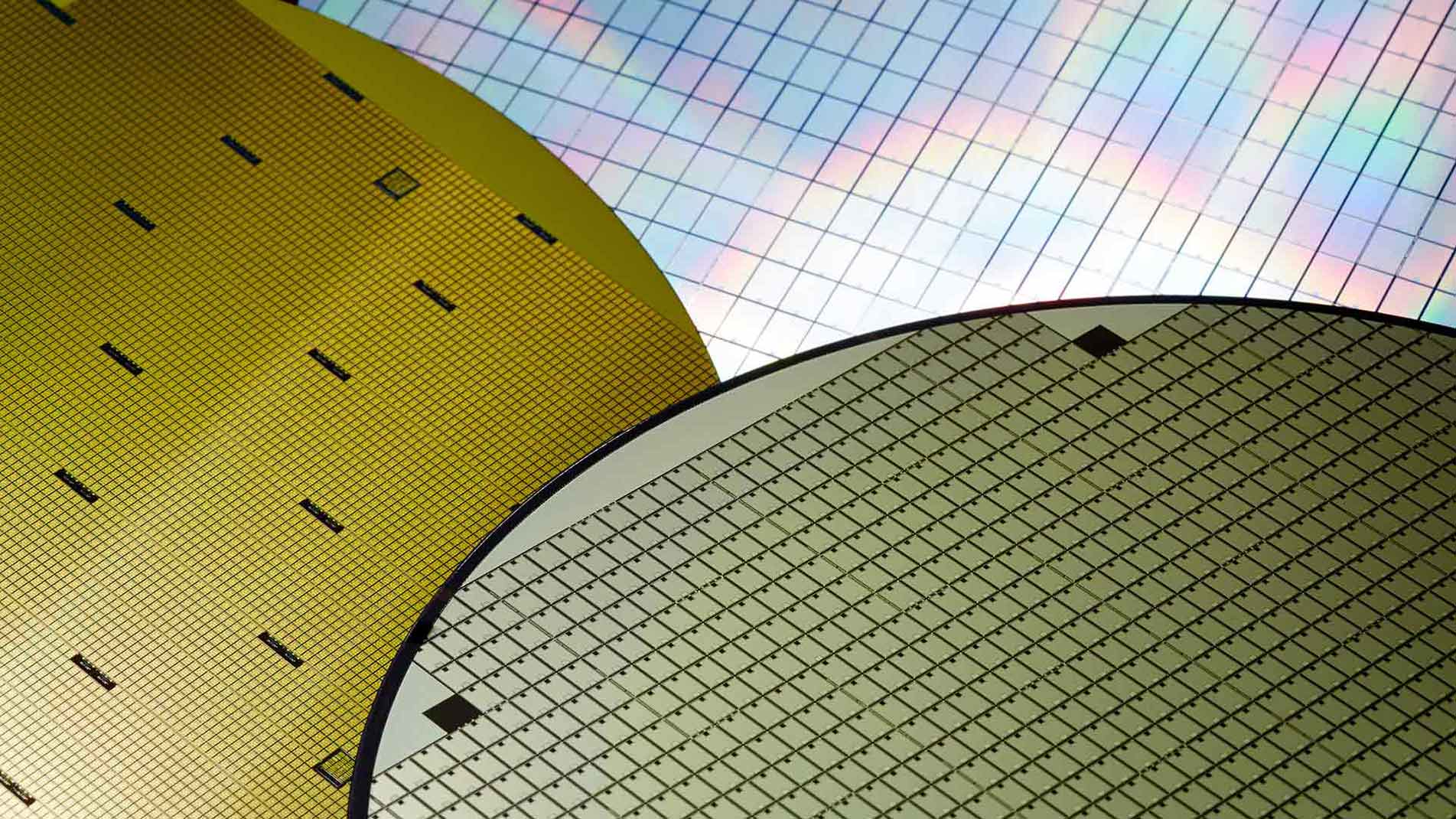
MOSFET元件供不應求,IDM又產能滿載,交期大幅拉長怎麼辦?完成了晶圓薄化與表面處理,後續又得將晶圓轉運去做CP和切割,有沒有一次就做到好的廠商?
