
正面金屬化製程是MOSFET晶圓薄化的一個關鍵製程,正面金屬化製程的目的,就是藉由濺鍍或化鍍方式形成UBM,接著做銅夾銲接 (Clip Bond),以降低導線電阻….

那要如何清楚透視微奈米級的線路避免專利糾紛?可利用大範圍掃描拍照拼圖達四萬倍、局部拍照可達百萬倍的掃描電子顯微鏡(SEM)來進行拍照…

大部分客戶,對於消費型產品規範都十分熟悉,當要跨入汽車電子時,最大問題就是不了解汽車電子要遵循哪些國際規範。如何用簡單三步驟,節省車電驗證時間與成本?…..

IC有問題,想抓出缺陷,卻總是選錯分析方式與儀器?近乎隱形的製程問題,奈米等級的表面汙染缺陷,該如何選擇到位的分析方式呢?宜特在驗證分析領域耕耘20多年…

MOSFET在電子產品扮演「開關插座」的角色由來已久,各家MOSFET廠商也都以追求高效率的電力轉換、低功率耗損為目標。為達此一目標的捷徑,就是降低RDS(on)(導通阻抗)…
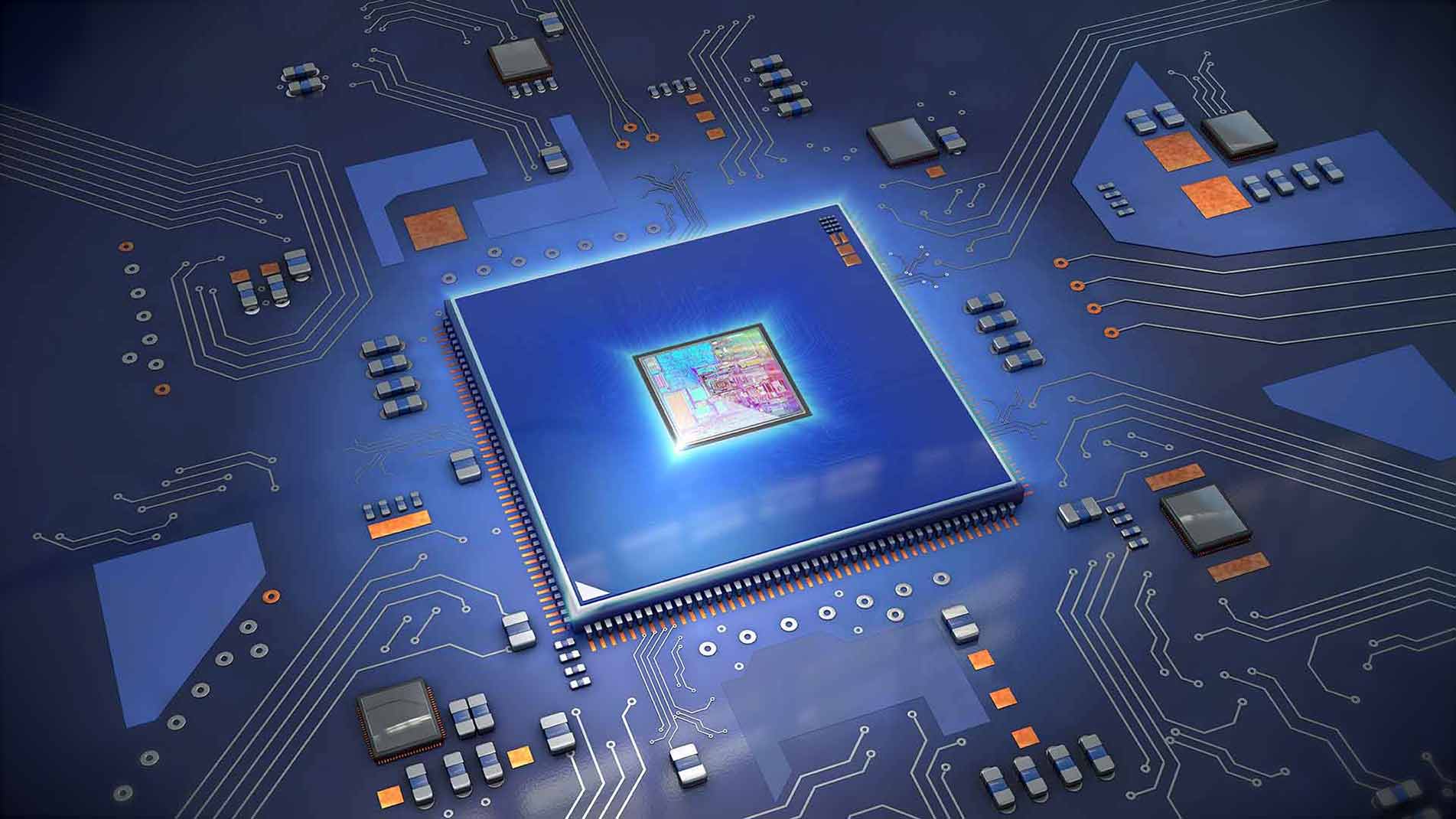
WLCSP IC進行FIB線路修補時將面臨兩大挑戰,一是IC下層的電路,會被上方的錫球與RDL給遮蓋住,二是少數沒有遮蓋到的部分,也會因上方較厚的Organic Passivation…..
