發佈日期:2017/5/23
發佈單位:iST宜特
通訊元件失效了,Bug警示燈號響起,原來是發生漏電。
漏電源(Hot spot)到底在哪裡? 失效分析的眉角在哪兒呢?
通訊晶片和一般以矽元素組成的晶片相比,最大的不同在於,通訊元件,封裝形式較單純,使用層數較少,因此在找失效點前的樣品製備上,不適合用delayer方式一層一層去除,因為容易也將缺陷點(defect)給去掉。
此外,通訊晶片主要原料是磷化銦(InP)、砷化鎵(GaAs),特別怕酸液的侵蝕,所以樣品去封膠的酸液調配就是關鍵,特別是不同製程的通訊晶片,配方比例就會有所不同。
完成樣品製備後,該如何串接各項失效分析工具,直搗黃龍找到Bug?
以下手刀奉上兩大經典通訊IC失效案例,讓我們來看看,宜特如何神速為客戶找到漏電源。
案例1:光通訊元件漏電,P電極端無法偵測,換個方向從N電極端下手,Hot Spot立刻現形。
光通訊元件漏電,P電極端(P-Electrode)有較厚的金屬層當電極層,遮蔽了漏電源(Hot Spot) (見下圖1-1)。宜特利用特殊的樣品製備手法,從N電極端下手,Hot Spot立刻現形(圖1-2)。
大範圍的找到漏電源之後,進行更進一步顯微切片分析結構觀察,發現金屬層與Substrate層的接合處,出現defect (圖1-3),因此研判,此defect就是造成通訊元件功能衰減而有漏電。

圖1-1:P電極端找不到

圖1-2:從N電極端,找到了
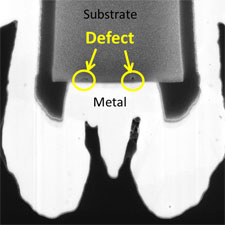
圖1-3:切片分析發現缺陷在接合處
案例2:樣品製備酸液配方是關鍵,簡單兩步驟,快速找到微波通訊元件Defect
微波通訊元件在樣品製備Decap時,酸液容易侵蝕樣品,宜特使用獨門的酸液配方,搭配精確失效分析工具選擇:
- 先利用OBIRCH大範圍抓到Hot Spot(圖2-1)
- 接著使用Dual beam FIB切片後(圖2-2),Defect立刻在絕緣層(Dielectric oxide)現形!發現絕緣層燒毀,使上下電極層(Electrode metal)有漏電現象。
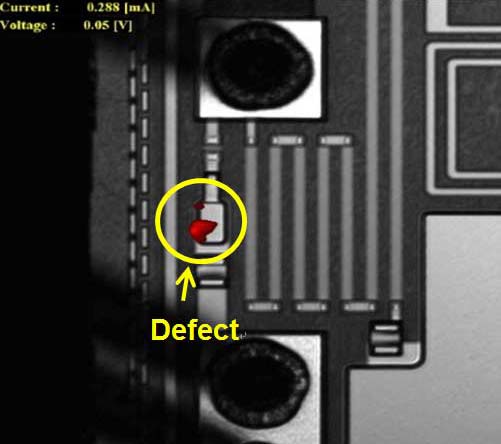
圖2-1:利用OBIRCH找到漏電源
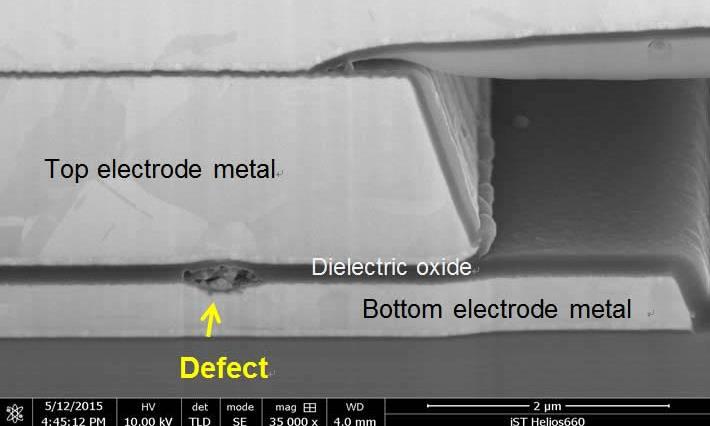
圖2-2:Dual beam FIB切片觀察,確認絕緣層燒毀造成漏電
本文與各位長久以來支持宜特的您,分享經驗,若您任何IC異常狀況不知如何分析,或是對相關知識想要更進一步了解細節,歡迎洽詢+886-3-579-9909 分機 6612 李先生(WenJie) │Email: web_ise@istgroup.com。
