
隨著製程越來越進步,對於污染缺陷點的分析要求也越來越嚴苛。這些表面汙染缺陷,該如何選擇到位的分析方式呢?一般而言,若待分析汙染物屬於有機物範疇,我們會選擇….

IC有問題,想抓出缺陷,卻總是選錯分析方式與儀器?近乎隱形的製程問題,奈米等級的表面汙染缺陷,該如何選擇到位的分析方式呢?宜特在驗證分析領域耕耘20多年…
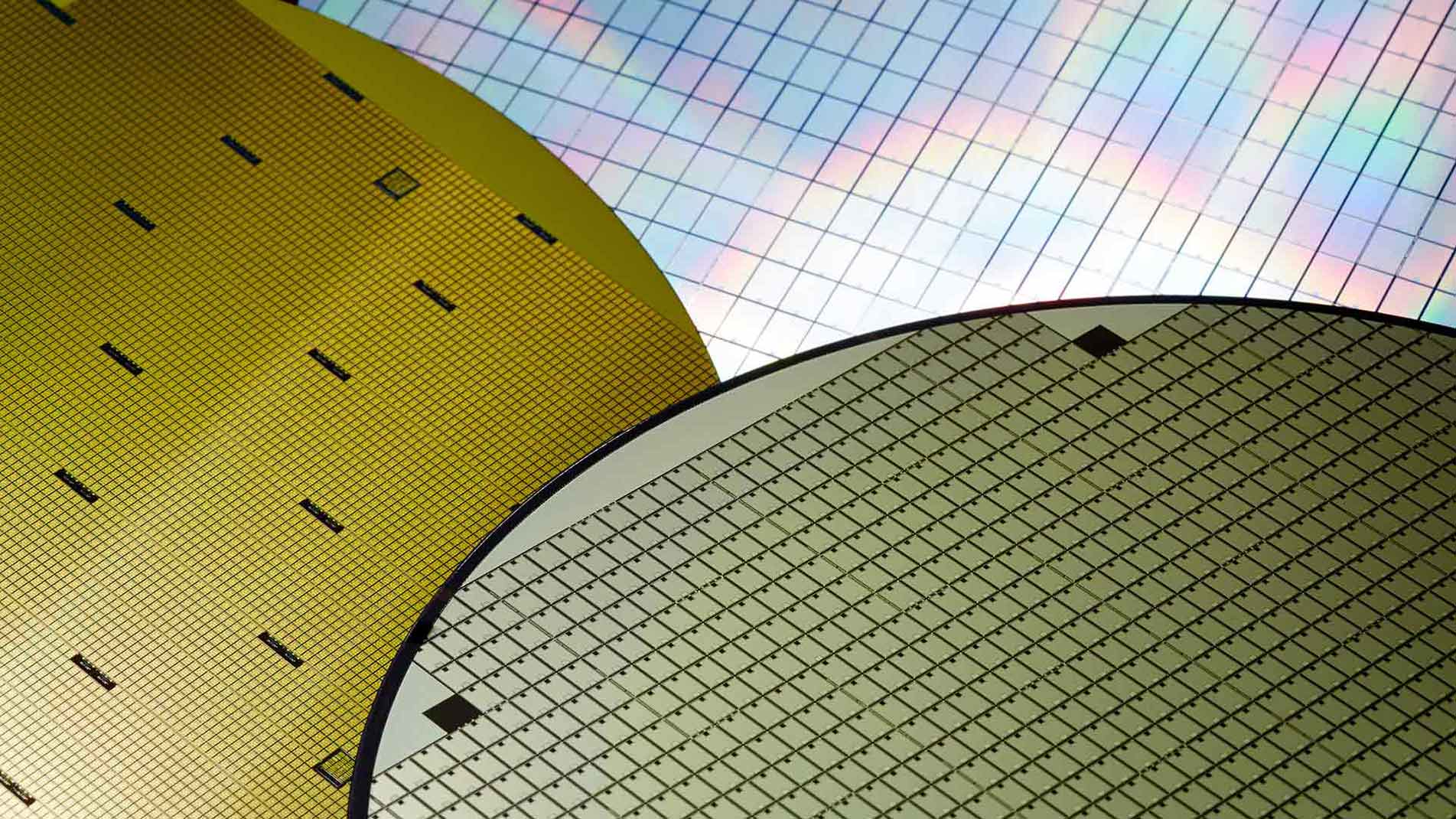

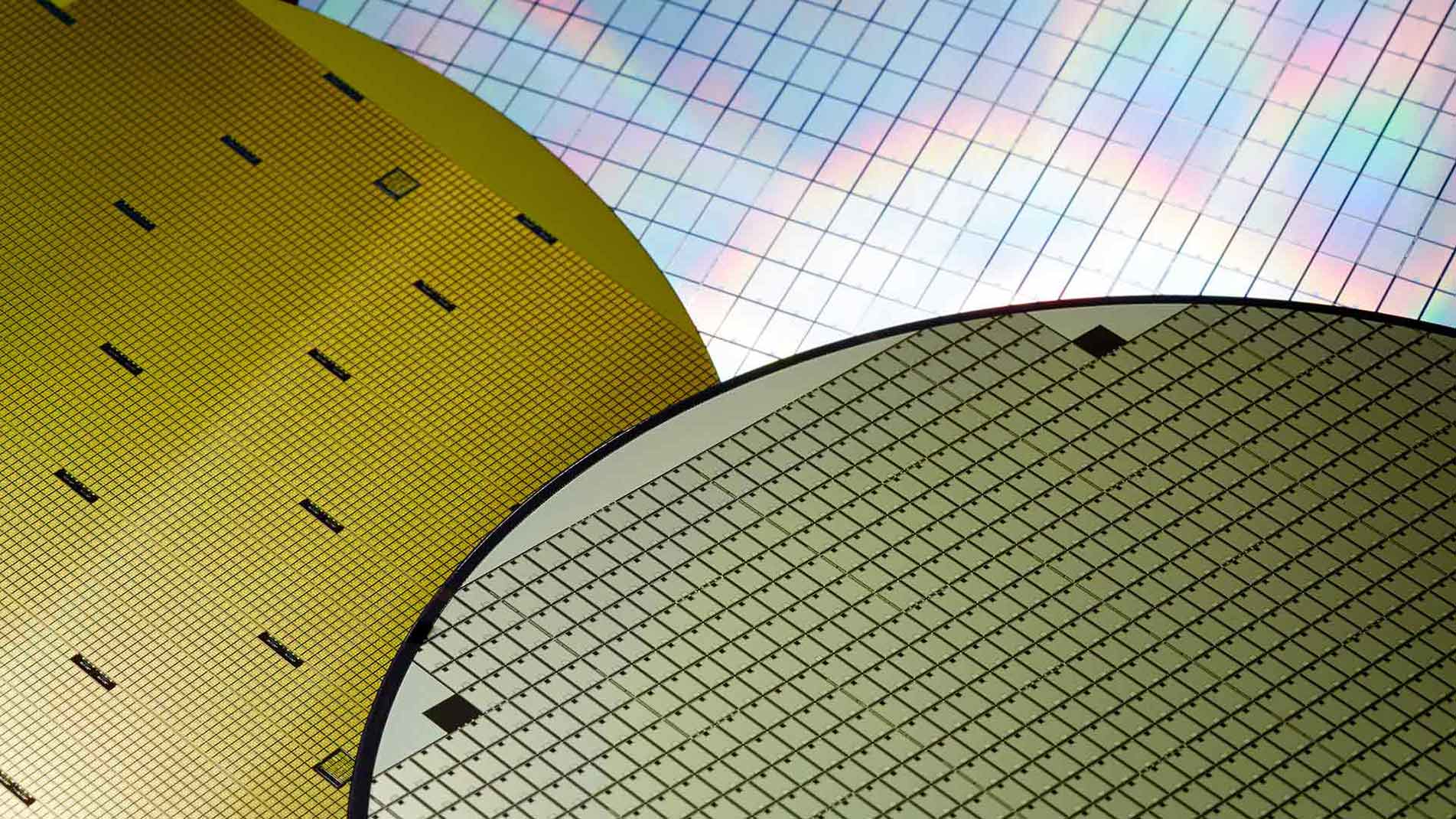
在晶圓尚未上電路(Pattern)之前,須了解晶圓是否平整,得以確認後續Layout狀況。當晶圓上了電路之後,更需監控粗糙度數據,才能確保後續上板後的品質…

常用來判斷P/N well的方式,是將晶片染色 (stain)後,再利用SEM(掃描式電子顯微鏡)拍攝其寬度、深度及量測磊晶層厚度,但是SEM的電子影像為黑白圖像,無法有確切的數據或顏色可以分辨P/N well,往往需要自行判斷與猜測…
