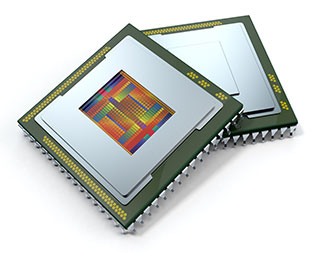
半導體IC不斷演進就是為了有更快的運算速度、較低功耗及降低成本等需求,於是製程技術的推進,概括可分為三大方向:
- 挑戰摩爾定律,從28nm-16nm-10nm-7nm-5nm一路往更小的製程推進
- 跳脫一般2D(平面)的框架,讓晶片可以堆疊成2.5D或3D的架構
- 更有效率的進行功率轉換及運用
針對上述三大方向,宜特不只可以在客戶產品發生失效時,協助客戶在短時間內找到自身產品失效狀況(failure mode)進而找出原因(Root cause),更進一步的為功率半導體客戶提供晶圓後段製程整合服務。
Step-by-step完成分析,找出失效狀況
當產品失效發生(R&D 或 RMA)需進一步解析時,宜特擁有完整的故障分析平台,從非破壞式分析開始,如: 超高解析3D X-Ray、SAT超音波掃描;電性量測分析,如IV量測元件的特性比較;故障點的定位,如: Thermal EMMI、InGaAs、OBIRCH等。
之後加上完善的樣品前處理技術,如: 樣品前處理技術,包括 IC開蓋(Decap)、IC層次去除(Delayer)、剖面/晶背研磨(Cross-section & Backside)、離子束剖面研磨(CP)等;搭配高解析之觀察工具,如: 場發式掃描電鏡(FESEM)、雙束聚焦離子束(Dual Beam FIB)。

而在材料分析方面,具備材料微結構分析與奈米級表面成分分析能量,如歐傑電子能譜儀(AES)、X光電子能譜儀(XPS)、穿透式電鏡(TEM)、二次離子質譜儀(SIMS)與EDS、EELS成份分析…等全方位分析技術,可解決客戶在材料分析上的需求。
而在功率半導體IC方面,宜特也透過子公司-「宜錦科技」提供晶圓後段製程整合服務,讓客戶的晶圓在離開前段代工廠後,可以直接來到宜錦科技進行正面金屬化製程:化鍍 /無電鍍 (Chemical / Electro-less Plating)、正面金屬濺鍍沈積 (Front Side Metal Sputtering Deposition);背面研磨製程:晶圓薄化(Wafer Thinning/ Non-Taiko Grinding/Conventional Grinding)、太鼓超薄研磨 (Taiko Grinding);背面金屬化製程:金屬蒸鍍沈積 (Metal Evaporation for Backside Metallization) 、厚銀製程 (Thick Ag Process)、背面金屬濺鍍沈積 (Backside Metal Sputtering Deposition)、電鍍 (Electro-Plating),以及後續晶片測試 (Chip Probing)、雷射刻號 (Laser Marking)、晶片切割 (Die sawing) 等,宜特以一站式服務協助客戶完成從晶圓到晶粒前的各項製程步驟。
另外,企業導入先進半導體製程的目的,是進入國際電子大廠電子供應鏈,有鑑於國際大廠對於供應鏈廠商的要求除了產品規格精進外,也包括品質管理、環保管理與CSR。因此宜特也提供全面品質管理(IATF 16949輔導)、環安衛與 ESG 增值服務、與溫室氣體水足跡盤查協助半導體產業加速進入國際電子大廠之供應鏈。

