發佈日期:2018/3/27
發佈單位:iST宜特
IC出現短路,進行開蓋(De-cap)後,短路現象卻消失了,懷疑是封裝體有缺陷,如何找Defect?
身為IC設計工程師的你,應該常遇到類似的問題。IC出現漏電、短路等異常電性問題,以為是自己的電路設計有問題,因此,來宜特進行IC開蓋(De-cap),準備做InGaAs、EMMI、OBIRCH等電性量測前,卻發現,IC開蓋後,所有的電性異常問題都消失了,IC恢復正常了。此時心情一則以喜、一則以憂,確定至少不是自己的設計有問題,但會是哪兒有問題呢?
這時候,問題就指向了「封裝體」。我們懷疑,有可能是封裝製程本身的缺陷。
一般而言,要找IC缺陷,通常需要用「破壞封裝體的方式」,包括IC開蓋、去黑膠等方式先進行樣品前製作業,但如果有可能是「封裝體」的問題,就不能使用破壞性的檢測方式。
本月小學堂,將帶來如何用不破壞樣品本身的方式,來找IC的Defect。
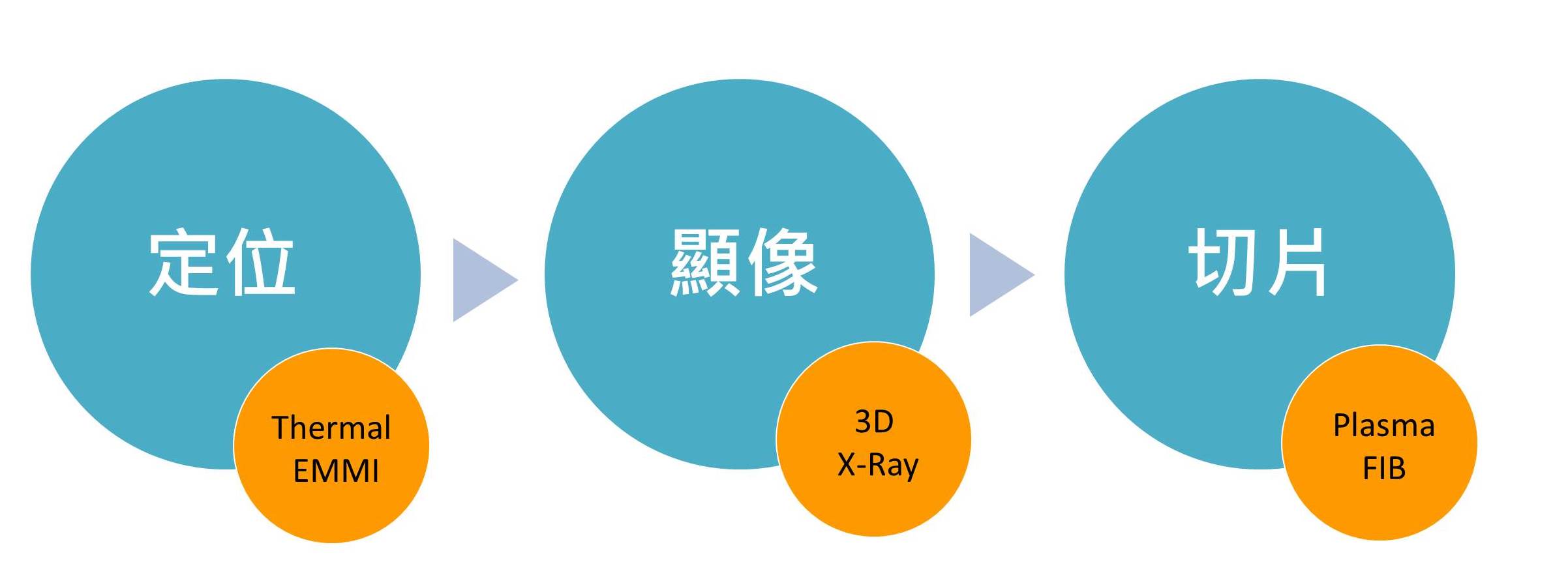
第一步驟 : 定位
在IC通電的狀態,且不破壞樣品的原貌下,利用Thermal EMMI故障點熱輻射傳導的相位差,
偵測 IC封裝的故障點深度(Z軸方向),快速定位故障點XYZ座標位置,並找到該異常點不是在Die 2本身,而是在封裝體的打線區(見圖一)。
第二步驟 : 顯像←→定位 來回驗證,縮小異常定位點,釐清相關異常點位置
利用3D X-ray,將失效位置影像在非破壞的狀態下,呈現出3D立體圖,檢視相關所定位之處是否有相關異常點(見圖二);若無明顯異常,需再將樣品作適當的處理後,執行「再定位分析」,讓相關異常點更明顯呈現,以利於後續相關分析(見圖三)。
第三步驟 : 切片
IC元件在封裝BOM的搭配上應力較弱,必須選擇低應力工具。但若使用傳統人工研磨,應力會產生嚴重破壞,因此選擇,利用低應力Plasma FIB將失效斷面切出並分析真因,找到封裝體內,原來含有不該出現的金屬物質-鎂(Mg)與鋁(Al),因而導致封裝體有異常漏電缺陷(見圖四)。此時也釐清了,在第二步驟時,為什麼利用3D X-ray觀測不到異常點(3D X-ray會穿透鎂鋁這種較為鬆散的金屬,而無法顯像)。
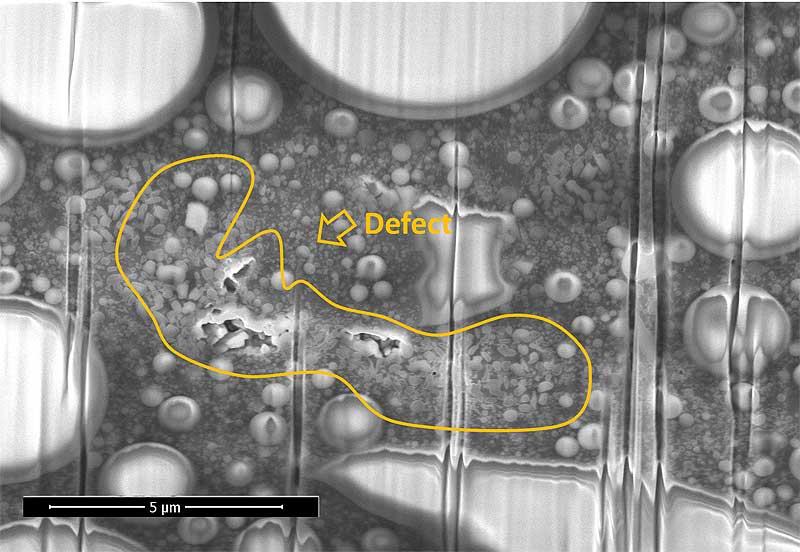
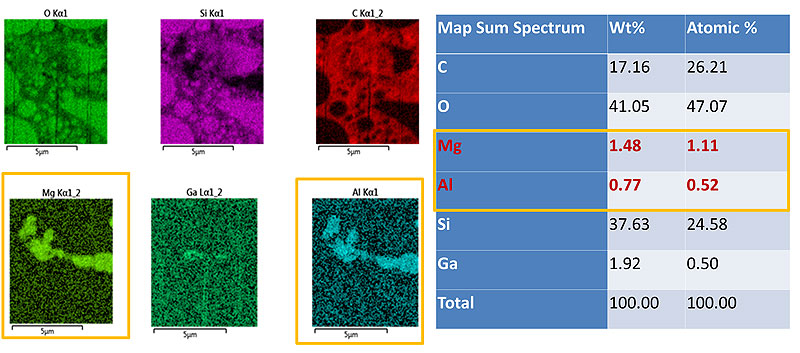
圖四:FIB X-S 顯示,封裝體缺陷含有鎂(Mg)與鋁(Al)的物質,此為造成 IC 電性異常的原因
本文與各位長久以來支持宜特的您,分享經驗,若您任何IC異常狀況不知如何分析,或是對相關知識想要更進一步了解細節,歡迎洽詢+886-3-579-9909 分機6767 陳先生 (Teron)│Email:web_ise@istgroup.com。