發佈日期:2018/1/25
發佈單位:iST宜特
量測晶體結構堆疊情形一定要破壞樣品?
是否有不破壞樣品的方式,輕鬆分析呢?
為什麼要量測晶體結構堆疊情形與薄膜特性? 通常在晶圓製程/LED製程研發階段時,必須確認樣品的晶體結構是否有堆疊整齊、觀測層與層之間的厚度、密度等數據,透過這些數據確定晶體有沒有乖乖地堆疊排列好。若沒有排列好,將影響到結構的強度、電性與透光度,進而影響產品品質。
而檢測晶體結構與薄膜特性,一般大家常使用的是TEM(穿透式電子顯微鏡),然而TEM主要是運用在微觀(奈米/微米)等級以下的結構檢測,樣品規格需要小於0.1mm(公厘),因此必須破壞樣品,切出欲觀察的那一層才能進行分析。
若要針對大於0.1mm(公厘)的巨觀範圍確認晶體結構堆疊情形與薄膜特性,同時又不想破壞樣品的前提下,就需要使用一項新工具-XRD(X光繞射分析)進行分析。
本月小學堂,將和您分享XRD,這個可以在不破壞樣品前提下,解析晶體結構堆疊情形,甚至還可以確認層與層之間接面的粗糙度、多層膜間的厚度、密度的利器(註一:其他檢測粗糙度利器)。
(一) 想知道XRD能不能幫助到您嗎?速看以下:
進一步了解XRD能夠做什麼
宜特近期引進的XRD(X光繞射分析),同時也搭載XRR(薄膜X光反射)功能。所謂XRD是用繞射原理得到繞射圖譜,並從圖譜資料庫比對,即可推論晶體排列結構;而XRR(薄膜X光反射)則是XRD的反射圖譜,藉此可以進一步得到 薄膜厚度(達0.1nm厚度的精準度);樣品表面、層與層的介面粗糙度;薄膜的電子密度;甚至可以進行多層膜分析(總厚度限制在500nm以下),為非破壞分析薄膜材料特性的絕佳工具。
圖譜資料庫? 圖譜長什麼樣子?如何比對?
XRD分析儀,它的原理是使用X光繞射,所以只能得知光譜數據,無法像TEM有樣品成像影像,不過可從得知的XRD數據圖,進入晶體圖譜資料庫進行比對,即可確認晶體堆疊狀況。相信您一定很好奇,圖譜長怎麼樣子?宜特如何協助您進行比對?
圖中紅色的繞射圖譜顯示出3個繞射峰(Peak),表示為多晶結構,經由軟體與資料庫比對為α-Fe BCC晶體結構。
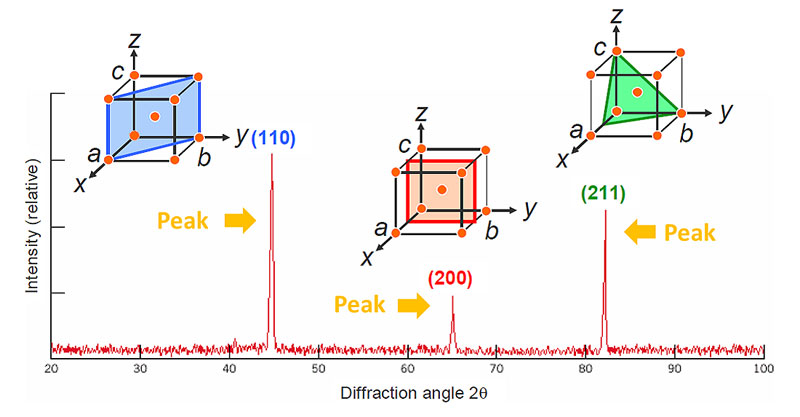
多晶α-Fe BCC結晶體的繞射圖譜
最小分析樣品的尺寸限制?
XRD主要是巨觀的分析晶體結構,無法像TEM觀看到奈米等級的,不過宜特可以提供最小達0.3mm,且強度更高(6kW)X光光源,並搭配雷射對焦技術,精準分析更小的圖像樣品,以獲取更強的訊號強度以提升更高的解析能力。此外,樣品分析尺寸也可達12吋晶圓大小。

產出的反射光譜長怎麼樣? 如何對照圖譜確認晶體結構?
圖中黑色為X光反射圖譜,而綠色為模擬相似結構的圖譜,經由軟體擬合(fitting)可以得到薄膜粗糙度,厚度以及密度的資訊。

(二) 各項樣品的案例分享
案例一:雙層奈米薄膜Al2O3之XRR分析
- 分析樣品: Al2O3/Si
- 說明: 以下是矽基材上成長氧化鋁薄膜的X光反射圖譜擬合的結果,從以下表格中可以看到實際上有兩層不同密度的氧化鋁薄膜,上下層的厚度分別為0.94nm與6.69nm;另外氧化鋁表面與矽基材介面的粗糙度分別約0.49nm與0.23nm。
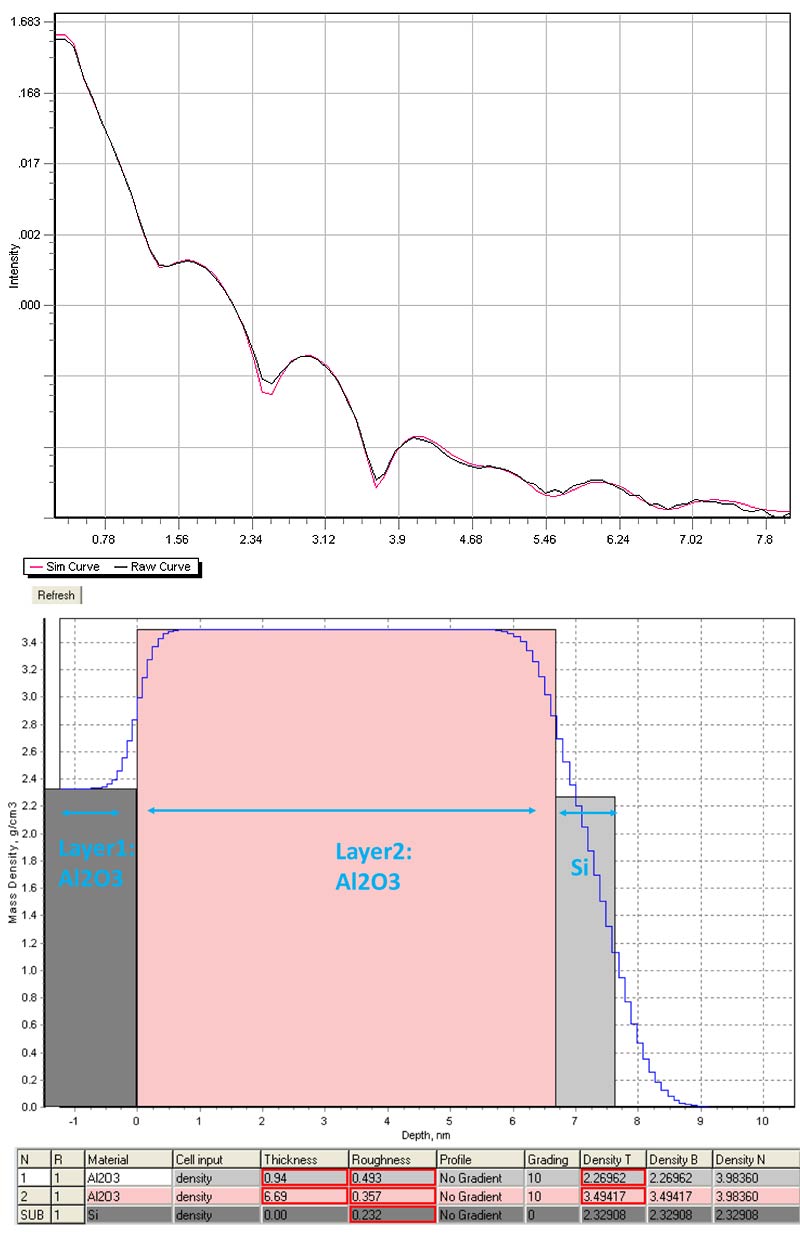
案例二:LED 磊晶高解析(HR)XRD分析
- 分析樣品: InxGa1-xN/GaN超晶格
- 說明: 以下是LED晶片磊晶結構的高解析X光繞射分析圖,從圖中擬合的結果,可以看到超晶格InxGa1-xN/GaN的厚度與組成比例分別為2.4nm/14.35nm與x=16.27%。

註一: 其他檢測粗糙度利器 AFM
對材料分析略知一二的您,一定知道AFM(原子力顯微鏡)也可以觀測樣品表面粗糙度,不過AFM只能看粗糙度,若要觀看樣品各層間的厚度、密度,以及層與層間的介面粗糙度就不是AFM的強項了。
註二: 材料分析各項的分析功能如下供參考
巨觀 微觀
表面粗糙度 XRD AFM
介面粗糙度 XRD /
多層膜厚度 XRD TEM
多層膜密度 XRD /
結構 / TEM
成分比例 XRD TEM-EDS
晶格缺陷/結晶性 XRD TEM
本文與各位長久以來支持宜特的您,分享檢測驗證經驗,若您有樣品結構需要判斷檢測,或是對相關知識想要更進一步了解細節,不要猶豫,歡迎洽+886-3-579-9909分機6613張先生(Johnson) Email: sa_tw@istgroup.com。

